Hiden Analytical Type 40010 SIMS Workstation
UHV surface analysis system for dynamic and static SIMS and SNMS. Designed for high-sensitivity depth profiling, surface composition analysis, and elemental imaging.
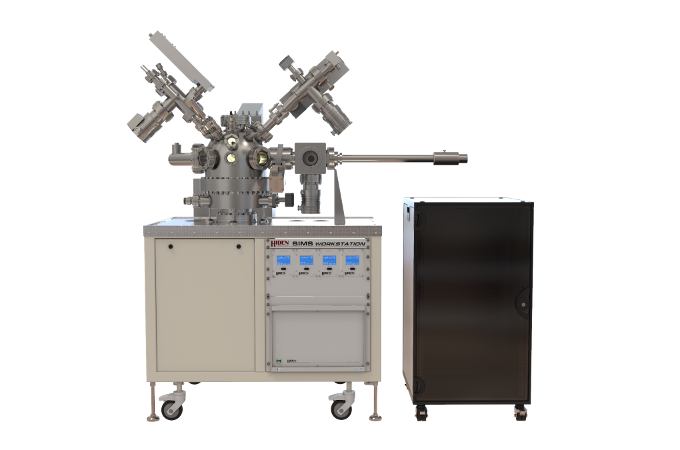
System Capabilities
The Type 40010 SIMS Workstation provides dynamic and static SIMS plus SNMS for surface composition and depth profiling within the top few micrometers of a sample.
A quadrupole SIMS/SNMS spectrometer supports positive and negative ion detection, depth profiling, and optional imaging for 2D and 3D chemical maps.
Operating Modes
Dynamic SIMS Depth Profiling
High-sensitivity depth profiles using a rastered primary ion beam.
Static SIMS
Low-dose surface spectra for molecular and fragment analysis.
SNMS Quantification
Quantitative depth profiles using sputtered neutral detection.
SIMS Imaging
2D elemental and molecular maps with optional 3D views.
Technical Specifications
| Mass Analyzer | MAXIM quadrupole SIMS/SNMS spectrometer |
|---|---|
| Mass Range | 300, 510, or 1000 amu (options up to ~5000 amu) |
| Depth Resolution | ~5 nm (typical thin film profiling) |
| Sample Size | Up to ~40 x 40 mm, max ~10 mm thickness |
| Vacuum System | UHV chamber with turbomolecular pumping and LN2 cryopanel |
| Primary Ion Sources | Configurable ion guns (e.g., Ar/O2, Cs) |
| Charge Compensation | Electron flood gun option for insulating samples |
| System Size | Approx. 2000 mm W x 1200 mm D x 1500 mm H |
Comparison: SIMS vs. XPS
Comparing SIMS depth profiling to a traditional XPS surface analysis workflow.
| Feature | This System (SIMS/SNMS) | Traditional Method (XPS) |
|---|---|---|
| Sensitivity | Very high trace sensitivity (ppm to ppb) | Lower sensitivity for trace species |
| Depth Profiling | Depth profiles through thin films and multilayers | Surface only (top few nanometers) |
| Analysis Volume | Surface to micrometer-scale depth | Near-surface only |
| Data Output | Mass spectra and depth profiles | Surface composition with chemical state information |
| Best Use | Trace analysis and depth profiling | Chemical state analysis of surfaces |